概要
走査透過電子顕微鏡(STEM)は、試料上に細く絞った電子線を走査させることで高倍率観察や元素マッピングを行うことができますが、試料を測定可能な大きさに加工(薄片化)する必要があります。
金属試料(アルミニウム)を集束イオンビーム加工装置(FIB)で薄片化し、STEMにより元素分布を求めた例を紹介します。
装置
○FIB 機種: SMI-3050 日立ハイテクサイエンス製(旧エスアイアイ・ナノテクノロジー)
○FE-TEM/EDS※ 機種: JEM-2100F 日本電子製
※走査透過電子顕微鏡(STEM)モードを使用
分析手順
1.アルミ板(図1左)の表面からFIBを用いて試料を切り出し試料台に固定
2.固定した試料を厚さ0.1μmまで薄片化(図1右)
3.STEM/EDSによる元素マッピングを測定(図2)
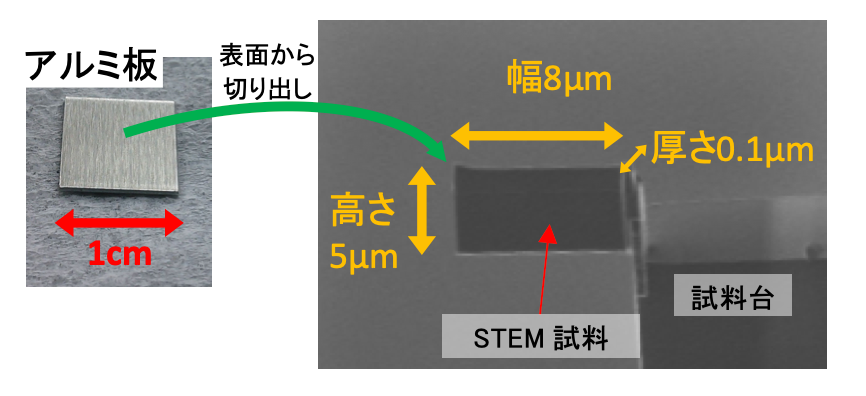
結果
STEM像観察の結果、アルミニウムの結晶粒子以外に、暗く写る粒子が観察されました(図2a)。
元素マッピングを測定すると暗く写る粒子部分から鉄が検出されたことから(図2c)、添加元素の偏析であることが予想されます。
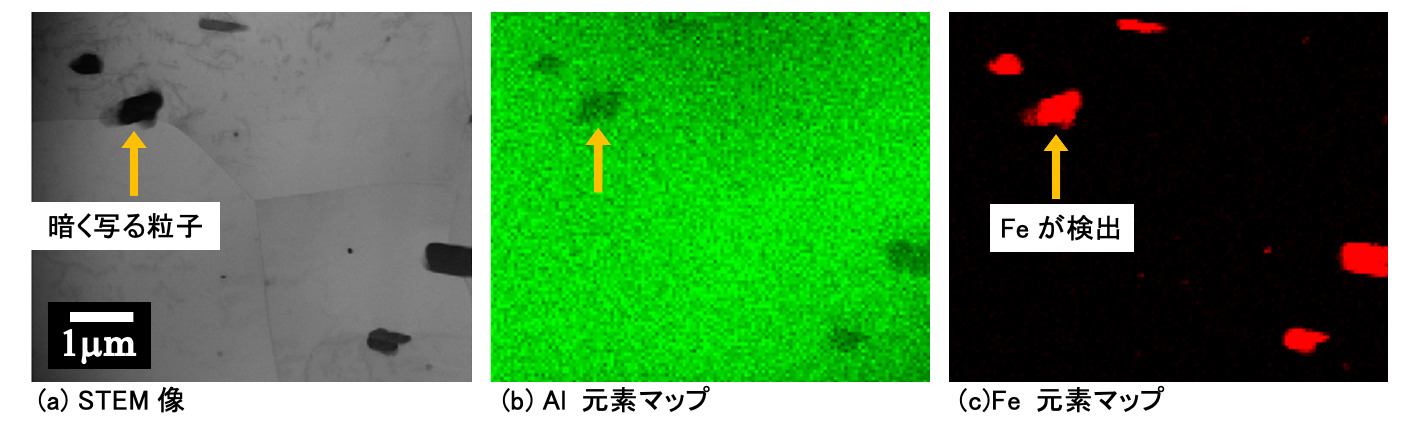
適用分野
無機材料、構造解析、形態観察
キーワード
金属、セラミックス、薄膜、電子デバイス
